- 插損測試重復(fù)性優(yōu)于0.2dB
- 高效的視覺算法,支持自動(dòng)扎針、自動(dòng)耦光、自動(dòng)清針
- 支持手動(dòng)以及自動(dòng)上下料
- 支持?jǐn)?shù)據(jù)庫定制
- 支持bar條、單die、藍(lán)膜等
- 可定制芯片分選、缺陷檢查功能
- 可定制測試算法、儀表選型等
- 支持OO/OE/EE/RF測試等
- 支持藍(lán)膜/芯片料盒等自動(dòng)上下料

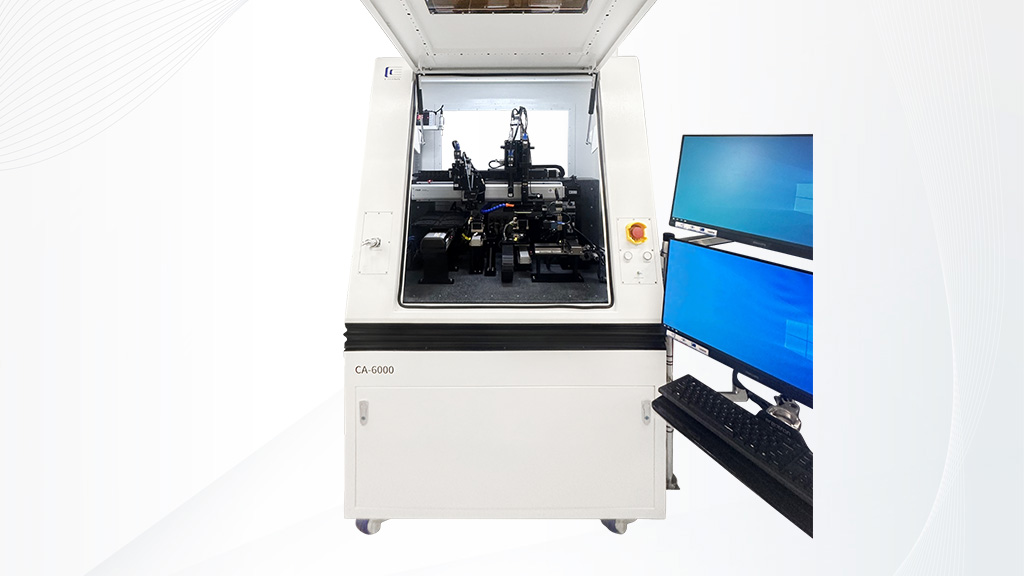
| 主要參數(shù) | ||
|
最小芯片模斑1 |
1.5 |
μm |
|
耦光重復(fù)性 |
< 0.2 |
dB |
|
光時(shí)間 |
初找光后,SMF < 10s, FA = 3min |
- |
|
光功率耦合精度誤差 |
≤ ±0.1 |
dB |
|
耦合方式 |
Grating Coupler、Edge Coupler |
- |
|
響應(yīng)模式 |
光反饋(功率計(jì))、電反饋(源表) |
- |
1. 如有特殊需要,請(qǐng)通過更換移動(dòng)平臺(tái)可支持更小模斑測試。
|
探針卡方案示意圖 |
DC探針方案示意圖 |
|
平面耦合重復(fù)性測試 |
10min穩(wěn)定性測試 |